[代发] 35年前‘硅的低温有序生长’,也许对今天的材料研究有启发 作者:丁成玉
--愿无偿提供给年轻人思路和技术诀窍接力探索
上个世纪70年代,在国内一个研究所从事半导体芯片工艺的研究,在试验中发现一些现象不大符合传统观点,比如薄膜的生长(淀积)速度,在温度低的情况下并没有减慢,特别是在低压时(此时参与反应的物质浓度是低的)速度也没有减慢。按着阿伦尼乌斯观点,反应速率常数与活化能和温度有关(见百度词条):
k=Ae-Ea/RT
k为速率常数,R为摩尔气体常量,T为热力学温度,Ea为表观活化能,A为指前因子
对于某个特定的反应,反应速率与反应速率常数也是相关的(见百度词条),温度高反应速度快,活化能是能够反应的门槛,活化能低,反应速度也会快。收集多个试验的结果发现活化能并不是一成不变的常数,通过他人的几个公式推导,发现活化能与反应物的平均自由程有关,就是平均自由程越长,活化能越低[1]:

把初稿寄给母校的老师唐敖庆教授(学部委员),几页回信予以充分肯定,说应该继续探索,在此鼓舞下,我收集了国内外几个人的反应数据(图上点好像不多,其中内含大量数据),计算各个系统的活化能与平均自由程作图,发现3个体系的斜率惊人一致,这样,‘活化能与平均自由程的关系’就得到了多个人的工作验证,图其中标注的文献可在[1]里面查到。见图一

理论工作是要指导实践的,按着这个思路,我们使用四氯化硅(一般是使用硅烷)在低温下淀积氮化硅薄膜:
SiCl? +N?+H?→Si?N?+HCl
这个反应在常压需要1200℃才能实现,器件需要的Si?N?薄膜是要在做好IC(集成电路)的上面淀积,对器件做钝化保护的,为了不影响已经做好的晶体管参数,显然必须在700℃以下才有意义。我们采用低压高频放电(即等离子体PCVD)得以实现,这不仅学术上有意义,就是在三线没有硅烷的情况下,当时是靠人背上火车,危险很大,经济意义上也是很大的。这个反应的副产品是HCl,对系统有清洗作用,可以把铁一类过渡元素形成低沸点化合物带走,而这类物质,常常使晶体管的性能变差(表现为‘软击穿’)。发现使用SiCl?产生氮化硅钝化膜后,晶体管的击穿特性明显变硬。
更发现使用氯化物还有新的作用,就是副产物HCl有腐蚀作用,使反应变成“可逆反应”。我们在“平均自由程”观点指导下,发现了SiCl?+H?硅的低温有序生长现象。按传统观念,只有在高温才能生长排列出“有序的晶体”。有报导在700℃,SiH?+H?系统,淀积的硅薄膜是无定形。我们从理论上推测,在平均自由程大的条件下,定位 ( 晶化 ) 活化能也会降低,淀积下来的硅原子可以在衬底上滑动一段距离,有机会选择能量最低的晶向排列,尤其是在有活性HCl存在的情况下,那些因为各种因素(如空间障碍、晶格缺欠等等)影响,也会有个别的原子会在能量高的地址沉积,这时如果有HCl存在,就会把这种高能量位置的硅重新反应生成SiCl?或者SiHCl?气化掉,这就是硅烷和四氯化硅的不同。实验证明了我们的设想,在 SiCl?+H? 体系,700℃,在各种衬底淀积硅薄膜,送到中科院物理所的半导体材料和电镜专家陈佳圭教授(见百度词条)分析测试,先做“红外吸收光谱”证明是硅薄膜,再做“反射电子衍射”以后,他还找来物理所的科技处长兴奋的告诉我,说这些硅薄膜都是有序的,沿着 <1 1 0 >晶向有序生长的!他们说液体硅在凝固时产生的晶须就是这个方向,因为原子按这个方向排列能量最低[2]。见图二
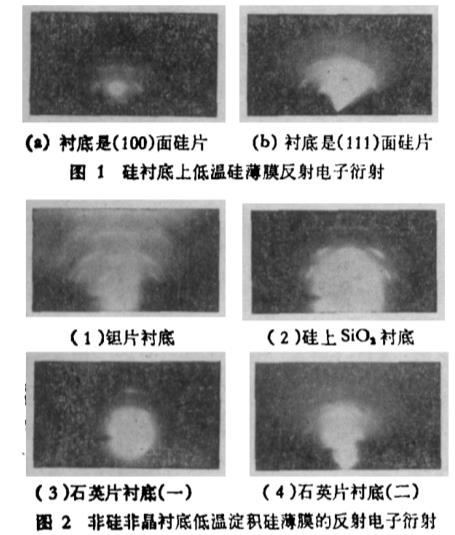
他们说这种现象还没有见过报导,在物理所也应该立项作为重点课题,可惜当时计划经济体制下人员无法调动,不能把你调入物理所研究。他们建议我深入研究,为此我与他们2人竟成为经常联系探讨学术的朋友。
后来我还使用四氯化碳做过碳化硅薄膜,预期增加集成电路的耐磨性,提高可靠性。还有碳薄膜,预期得到金刚石薄膜,以便集成电路散热。这两个薄膜表面非常光亮,十年前回国看,仍然光亮。遗憾的是,没有继续研究,因为山东省的一个地级市通过当时七机部长,“引进人才”使我离开了研究所,到了地方,思路改变了,重视实践了,放弃理论研究了。这两个样品没有分析其结构,按现在的认识,按照能量最低排列观点,猜测很可能是‘石墨烯’呢(建议后人试验)。
好在后来我在山东研究“低噪声基准电压器件”(使用传统工艺,但是结构巧妙,表面氮化硅薄膜是本法),也是他们帮助测试的,陈教授还是国家“微弱信号测试基地”的专家,他检测我们的器件噪声时,很出他们的意外,开始不相信,反复检查仪器,对比测试发现我们的器件噪声电压小于1微伏。处于同类产品的领先地位,这也是他们的测试极限,当时他们正在为某个工程寻找急需的这种低噪声器件,那时用宝贵外汇进口的这种器件最好的标称噪声电压是10微伏左右,但是“挑选率”很低,很少有达标的。我带来的十几个,基本上都是低于1微伏,他们立即推荐给重点工程,效果明显,大大提高了该工程的精度。后来他们主持鉴定并推荐,获得了国家发明奖,《新闻联播》有过报道,这是后话。
这个“低温有序硅薄膜”我离开研究所后,没有条件进行制作掺杂等试验。但是作为一种新型材料,特别是非晶衬底上的有序硅薄膜,希望有年轻人接力研究,因为设备和工艺简单,投资不大,一旦有进展,应该是个突破,有可能改变芯片结构和产生新的器件。我现在进入耄耋之年,年老体衰,眼睛黄斑病变,视力不佳,希望把这个思路,和工艺诀窍细节无偿提供给年轻人,让后来人接力进行,以期贡献给社会,建议在非晶衬底淀积这种硅薄膜,做晶体管,碳薄膜做结构测试,预期会有重大进展,学术意义和经济效益前景十分广阔。有意者请尽快联系。
[1]:《自然杂志》3卷10期 1978,723
[2]:《半导体技术》3 1979 ,57